오늘은 주목해야 할 국내 패키징 업체를 소개해드리려고 합니다.
반도체 공정 8개를 이해하지 못해도 이해할 수 있도록 관련 내용을 정리했습니다. FST에 이솔이라는 막강한 자회사가 있다면 네패스에는 국내 유일의 FOPLP(Fan-out Pannal Level Packaging) 기술을 보유한 자회사가 있다. 오늘은 연차보고서를 바탕으로 네패스에 대해 알아보고, 네패스 시트에 대해 이야기하고 프레젠테이션으로 마무리하겠습니다.
회사를 분석하기 전에 몇 가지 기본적인 패키징을 살펴보겠습니다.
패키징 공정은 반도체를 완벽한 제품으로 만드는 마지막 공정입니다. 외부 환경으로부터 반도체를 보호할 뿐만 아니라 내부의 열을 방출하여 전기적으로 연결하는 공정입니다. 즉, 집적회로와 전자소자를 연결하여 고온, 다습, 화학약품, 진동, 충격으로부터 회로를 보호하는 방식으로 칩의 소형화 속도가 한계에 다다르면서 부각된 분야이다. 최근 몇 년 동안. 파운드리 최강자인 TSMC는 당시 신기술인 패키징 기술인 FOWLP(Fan-out Wafer Level Package)로 애플의 물량을 놓고 삼성전자를 제압할 수 있었던 것으로 알려졌다. TSMC가 Apple에 의해 FOWLP로 선정되기 전에는 패키징 프로세스가 프런트 엔드 및 프런트 엔드 프로세스보다 덜 눈에 띄는 것으로 취급되었습니다.
(포장과정)
1. 웨이퍼 연마 및 절단
– 웨이퍼의 칩은 수백 개의 스크라이브 라인으로 구분됩니다. 다이아몬드 톱이나 레이저 빔으로 이 스코어 라인을 따라 절단하는 과정. 이 공정을 다이싱 또는 톱질이라고 합니다.

2. 첨부파일
– 칩을 실은 리드프레임이나 인쇄회로기판(PCB)으로 옮겨진다. 칩과 외부 회로 사이에 전기 신호를 전달하고 외부 환경으로부터 칩을 보호하는 골격 역할을 합니다.

3. 금선 연결
– 기존의 와이어 본딩 방식과 와이어 본딩 방식의 단점을 극복하기 위해 최근에는 범프를 이용한 플립 칩 본딩이 주로 이용됨
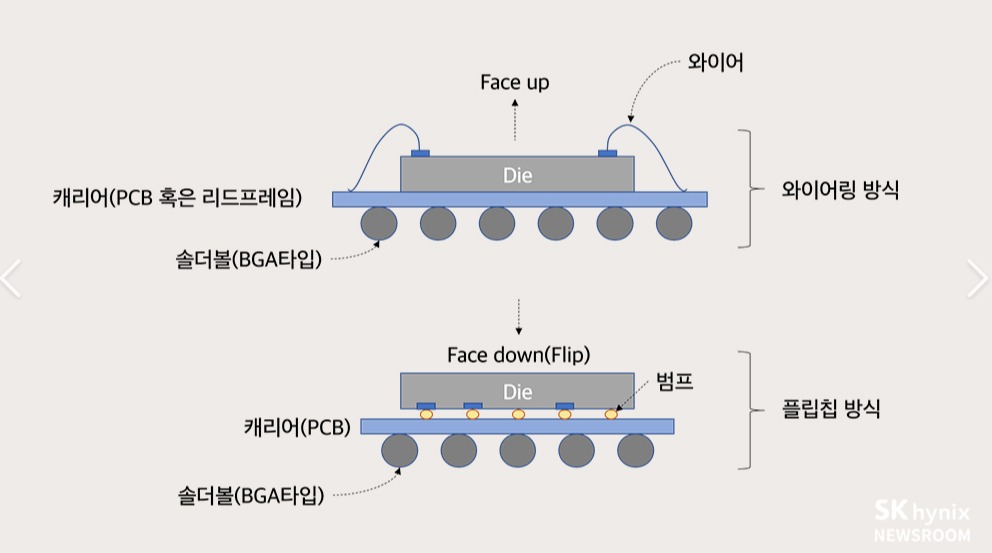
와이어 본딩은 와이어를 이용해 외부 표면을 연결하는 반면, 플립 칩 본딩은 범프를 이용해 연결해 칩 1개당 부피를 줄이고 연결 속도를 높일 수 있는 장점이 있다. 칩이 빌딩이라면 외부계단이 와이어본딩이라면 범퍼는 엘리베이터, 플립칩 방식은 엘리베이터로 층을 이동시킨다. 건물을 오르기 위해 계단을 사용할 때 건물 외부의 별도 공간을 사용하여 계단을 만들어 건물의 실제 가용 부피를 줄입니다.
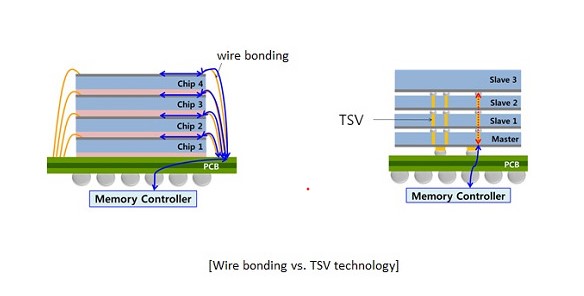
그러나 플립칩이라는 엘리베이터는 한 층만 이동할 수 있는 엘리베이터로, 쌓인 높은 층에는 사용할 수 없다. 따라서 고층 엘리베이터인 TSV(Through Silicon Via) 본딩 공정과 함께 사용되는 경우가 많습니다. TSV는 위 그림과 같이 칩에 미세한 구멍을 뚫어 상하부 칩과 전극을 연결하는 패키징 기술입니다.
4. 성형 공정
– 반도체 칩을 열과 습기 등의 물리적 환경으로부터 보호하기 위해 화학수지로 밀봉한 후 원하는 모양으로 성형하면 우리가 흔히 보는 반도체의 모습이 된다.
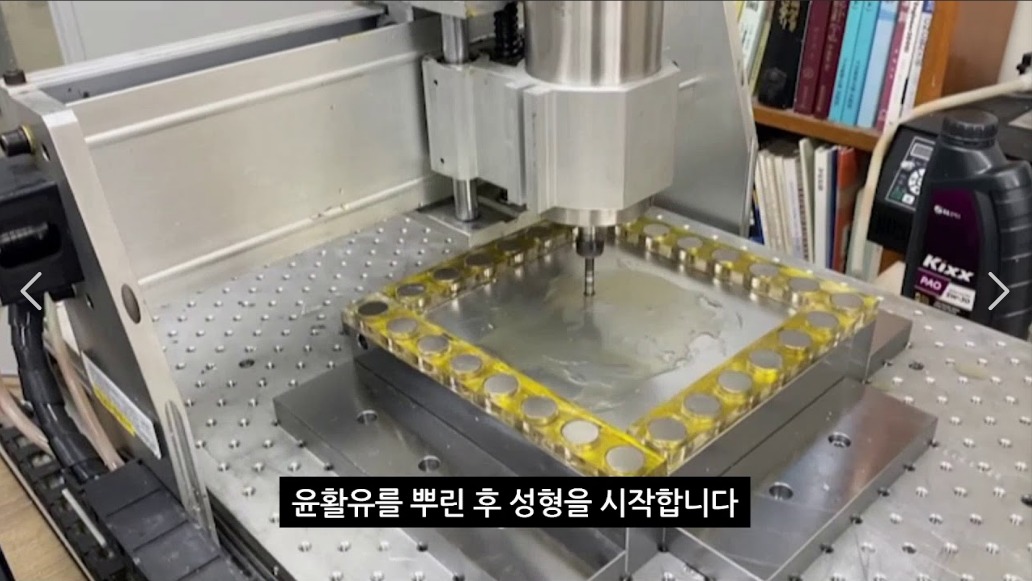
5. 패키지 테스트
– 패키징 공정을 마친 반도체 칩은 최종 테스트를 거쳐 우리 삶의 다양한 분야에 활용되고 있습니다. 이 과정은 최종 고장을 선별하는 단계를 말하며 패키지 검사장치인 테스터에 삽입하여 전압, 전기적 신호, 온도, 습도 등의 다양한 조건을 적용하여 전기적, 기능적 검증을 하고, 제품의 작동 속도. 이 테스트는 완제품에 대해 테스트하기 때문에 최종 테스트라고도 합니다. 이러한 최종 테스트는 관련 데이터를 분석하고 제조 또는 조립 프로세스에 피드백을 제공하여 제품 품질을 향상시키는 데 중요한 역할을 합니다. 이런 식으로 향후 수율 향상에 영향을 미칩니다.

Apple의 마음을 사로잡은 것은 다음과 같습니다. TSMC의 FOWLP와 삼성전자가 TSMC와 공동으로 개발한 최신 패키징 기술인 FOWLP피알아 보자.
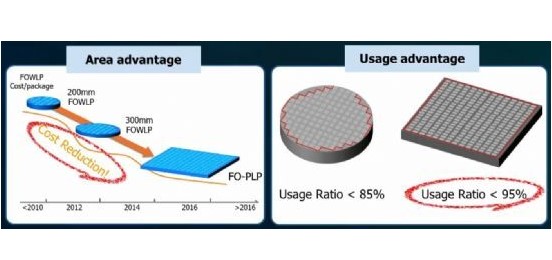
1) WLP와 PLP의 차이점
– 펀칭된 칩을 웨이퍼 뒷면에 위치 원형 웨이퍼 위에 배열된 WLP(Wafer Level Package)아니 어떻게 사각 패널로 패키징되는 PLP(Panel Level Package)는 원형 웨이퍼 형태로 칩을 결합한 WLP 전체 면적의 85%까지 사용할 수 있는 반면 별도의 사각 패널() 차세대 패키징은 삼성전자가 개발한 첨단 기술로 최대 95%까지보지마. WLP와 비교하여 PLP는 한 번에 패키징할 수 있는 칩의 수를 줄입니다. 10~20% 이상, 원가절감할 수 있다는 장점이 있습니다. 단, 기존 웨이퍼 공정 장비는 사용할 수 없음 판가공이 가능한 신규 장비 개발이 필요하고 최소한의 패터닝 능력도 WLP만큼 좋지 않다.업계에서 가지고 PLP는 WLP에 비해 진보된 기술로 평가되지만 신규 장비 개발에 따른 뒤틀림, 소재 간 열팽창계수 차이 등의 요소를 해결해야 함유적. TSMC와의 파운드리 경쟁에서 삼성전자는 세계 최초로 첨단 공정 GAA를 도입했을 뿐만 아니라 패키징 공정에도 FOPLP 공정을 도입해 기술 주도권을 잡았다.가지려고 노력하다
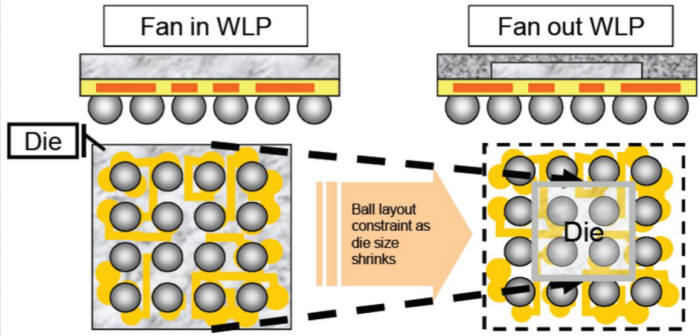
2) FI와 FO의 차이점
– FO(Fan-Out)는 칩 크기보다 큰 면적에 볼이 있는 구조로 이때 볼은 칩(다이)과 보드를 연결하는 역할을 하여 전기적 기능을 수행할 수 있다. 이에 반해 FI는 Fan-In의 약자로 정육면체의 면적이 구형이다. 현재 반도체의 미세화로 인해 다이(칩)의 크기가 작아지는 상황에서 칩 크기에 맞게 FI의 볼을 줄여야 한다. 따라서 대량으로 볼을 배치(배치)하기 어렵다는 단점이 있다. 또한 FO는 FI보다 큐브(칩)당 볼의 개수가 많아 패턴의 효율성(전기적 이동 속도 등)을 높일 수 있어 최근 널리 사용되고 있다. 기존 FIWLP 방식은 패키징 후 웨이퍼를 슬라이싱하지 않고 슬라이싱하는 방식이었다. 하지만 이 방식은 불량품인 불량 칩까지 통째로 포장해야 하는 문제가 있었다. 이러한 문제를 해결하기 위한 프로세스가 TSMC에서 개발한 FOWLP입니다. 패키징 후 웨이퍼를 다이싱(슬라이싱)하는 대신, 슬라이싱 후 좋은 제품만 재배치하여 패키징함으로써 FIWLP에 비해 원가 절감이 가능합니다. 또한 FO이기 때문에 칩 면적당 볼 수가 많고 패턴 효율이 좋아 최근 가장 많이 사용되는 방식이다.
국내 3대 패키징 업체는 네패스, 에스에프에이, 하나마이크론이다. 그 중 에스에프에이는 최신 패키징 공정의 근간이 되는 플립칩 공정의 핵심기술을 보유하고 있으며 하나마이크론은 플립칩, WLP, MCP(멀티칩 패키지) 등 다양한 패키지군을 생산하고 있다.
오늘 이야기할 네패스와 그 자회사는 턴키 패키징과 테스트 볼륨을 공급합니다. 여기 턴키는 포괄적인 주문계약을 의미하며 레스토랑에서는 음료부터 메인, 사이드까지 코스 메뉴가 제공된다.또한 네패스의 자회사인 네패스 로웨의 PLP 관련 기술은 국내 유일의 기업이다.
1. 개요
당사는 첨단 후공정 파운드리 사업과 반도체 및 디스플레이 제조 사업에 사용되는 전자재료 사업으로 나뉩니다. 반도체 사업은 스마트폰, 웨어러블 등 다양한 칩셋에 대한 WLP(Wafer Level Package), FOWLP 및 FO(FI) PLP 기술로 국내외 플립칩 범핑 기술을 성공적으로 상용화하고 확고히 자리매김하고 있으며, 전자재료 사업을 중심으로 현상액, 식각액, PR(감광액), 세정제 등 소재산업에
최근 반도체 사업에서 시스템반도체의 중요성이 부각되면서 시스템반도체 시장은 메모리 시장(메모리 2.5 : 7.5계)의 3배 이상 규모로 현재 IT 애플리케이션 시장을 주도하는 제품은 are mobile 지능형 기기를 기반으로 하고 있으며, 이를 구성하는 대부분의 부품이 시스템반도체입니다. 우리의 OSAT(Advanced Post-Processing) 사업은 파운드리 시스템의 반도체 공급망에서 핵심 공정으로 국내뿐만 아니라 세계 기술의 선두 주자입니다.
전자재료는 케미컬 시장의 특성상 변동성이 적고 기능성 케미컬이 매출에 기여하기 시작했다. 특히 전자재료 사업은 높은 국내 시장점유율과 기술적 노하우로 수입에 의존하던 화학물질을 찾아내어 내재화를 통한 신원조회를 통해 주요 거래선에 신규 매출을 기대하고 있습니다.
2차전지 부품을 찾아 ESS 및 EV 배터리에 적용하여 급성장하는 에너지 공간으로 확장하고 있습니다.
2022년 3분기 총매출은 4,469억원이며 반도체 매출은 3,516억원, 전자재료는 412억원, 이차전지는 541억원이다.
2. 유통경로

3. 영업전략
1) 반도체 사업
– 선도적인 기술개발과 차별화된 연구를 바탕으로 안정적인 시장점유율 확보
– 글로벌 마케팅을 위한 고객 서비스 강화
2) 전자재료 사업
– 신규 케미칼 출시에 따른 디벨로퍼 중심의 영업 구조로 고객 중심의 영업 강화
– 기술영업력 강화, 반도체 및 TFT-LCD 업체 라인 확대, 신규업체 선판매, 해외법인을 통한 국제 네트워크 구축, 직수출 추진
4. 연구개발
1) 연구개발비

높은 R&D 수준을 감안할 때 회사는 성장을 위한 기술 개발에 열심인 것 같습니다.
2) 연구개발 실적
-지난 3년간의 연구 결과


다섯 번째 상태
1) 시장의 특성
반도체 사업분야인 시스템반도체 분야의 고객사는 LCD 드라이버 범핑 기술을 국내에 국산화하여 국내 최초로 삼성전자, DB하이텍 등과 장기공급계약을 체결하여 안정적인 고객 및 공급처를 확보하였습니다. 턴키 프로세스를 가지고 있습니다. 2012년부터 글로벌 주요 비메모리 디자인 하우스의 반도체 업체들과 제휴하여 WLP(Wafer Level Packaging) 및 FOWLP(Fan-out WLP) 기술을 공급하고 있습니다. 전자재료 사업 분야에서는 반도체 완제품의 대부분을 수출하고 있으며, 원자재는 국내 신용장으로 현지 수출을 통해 구매하고 있습니다. 반도체 및 LCD 제조사의 생산 공정은 연속적이고 생산성 향상을 고려해야 하기 때문에 선별된 소재만으로 고객 전환이 쉽지 않아 안정적인 수요를 기대할 수 있다. 또 스마트폰용 전력관리용 반도체 시장점유율도 점차 높아질 전망이다. 또한 시스템반도체 산업은 자체 소자의 가격 경쟁력을 확보하고 안정적인 수급을 위해 국산화를 진행 중이며 자체 기술력을 바탕으로 고객과의 협력을 통해 지속적인 제품 개발을 추진하고 있다.
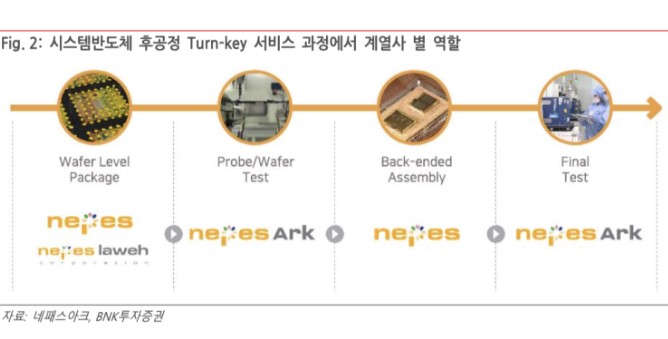
2) 신규 사업 내용 및 전망
글로벌 시스템 반도체 기술 로드맵은 자체 최종 조립 공정 기술로 빠르게 전환되고 있습니다. 또 시스템반도체의 주요 제조망이 대만에서 한국(삼성전자)으로 옮겨가고 있다. 이러한 관점에서 네패스는 글로벌 Top Tier 고객들과 협력하여 세계 시장을 선도하기 위해 첨단 기술과 생산 능력을 확장해 나가고 있습니다. FOWLP 관련 원천기술과 공정혁신 기술을 활용해 혁신적인 첨단 제조설비인 FOPLP를 구했고, 이를 통해 시스템반도체 핵심 밸류체인으로 성장할 것으로 기대된다. 여기서 마무리한다는 것은 두 가지 방법으로 생산 라인에서 병목 현상이 발생하는 지점에서 처리 능력을 높여 전체 생산 효율성을 높이는 것을 의미합니다.
6. 자회사

1) 주요 자회사
– 네파의 방주
반도체 후공정 테스트 솔루션을 제공합니다. 주요 제품군으로는 전력반도체(PMIC, Power Management IC), 디스플레이 구동칩(DDI, Display Drive IC), SoC(System on Chip) 및 기타 AP(Application Processor), RF(Radio Frequency), 5G 모뎀칩 등이 있다. 2021년 하반기 네파슬레이브의 FOPLP(Fan-out Panel Level Package) 제품 테스트가 시작되어 이미지센서(CIS, Cmos Image Sensor) 입점을 준비하고 있습니다. 현재 2021~22년 631억 원 규모의 신규 설비 투자가 예정되어 있어 향후 매출 성장이 기대된다. 이병구 대표(전 LG반도체), 이창우 대표(전 네패스 상무) 등 주요 경영진은 네패스와 전 LG반도체 직원들이다. 네패스 계열사 중 유일한 상장기업이다.
– 네팔어

– 네패스 야하드
터치스크린 패널을 제조하는 자회사
– 네패스건설
부동산 임대업 및 토목사업을 영위하는 자회사
– 이리도스
LCD용 Color Paste를 운영하는 자회사입니다. CEO는 Rodrigo Elizond와 이병구입니다. Solvay SA가 49.34%, Nepes가 49.34%를 소유하고 있는 합작 회사입니다.
7. 본론
1. 네파슬레이브 자회사의 경우 삼성전자 전용 FOPLP를 제조하는 회사로 보이는데 삼성전자의 의뢰로 만들어진 회사인가?
– 설마. 미래의 성장 잠재력에 투자하고 있음을 알 수 있습니다.
2. PLP 프로세스를 수행하기 위해 다음과 같이 해결해야 할 요소가 있음을 알고 있습니다. 나. 새로운 소자의 개발 및 재료간 열팽창계수 차이로 인한 뒤틀림 발생. 이 부분은 어떻게 해결하시나요?
– 이미 해결되어 양산중입니다.
3. 패키징 공정에서 PLP 공정의 확장성은 회사의 성장과 밀접한 관련이 있는 것으로 보인다. 해당 기술의 확장성에 대해 말씀해 주시겠습니까?
– 일반적으로 반도체의 성장률이 연간 3~5%라면, FOPLP는 4배 성장할 것으로 예상됩니다.
3. 네파슬레이브의 자회사인 네파샤임의 사업분야는?
– FOPLP 거래를 합니다.
3-1 그렇다면 Lawe와 Haim의 차이점은 무엇입니까?
– Lawe는 정방형, Haim은 원형으로 필리핀에 위치하고 있습니다.
4. 네패스아크 CIS 테스트는 언제 시작되나요?
– 현시점에서 가장 먼저 하고 있는 지원서에 대한 회신이 있으며, 2~3년 정도의 공백이 있습니다.
5. 네패스 아크 신공장 21-22일 공사중인데 완공인가요? 언론 내용을 보면 공시에는 고정자산 투자액이 995억 원과 631억 원의 차이가 있다. 어느 것이 맞습니까?
– 공개가 맞습니다. 아시다시피 지금 반도체 업계가 여건이 좋지 않아 서두를 필요가 없습니다. 해당 시설은 2023년 2분기부터 입주할 예정이다.
5-1 이번 거래의 상대방은 반도체 테스트 장비를 공급하는 미국의 테라다인 외 4개사다. SoC 및 AP 관련 설정인 것이 맞습니까?
– 예, 하지만 어떤 종류의 장비를 설정하느냐에 따라 다릅니다. 내가 설정하는 주요 제품에 따라 다릅니다.
5-2 네패스아크의 신규 CAPA 확대로 예상되는 매출은 어느 정도인가?
– 음, 디자인 CAPA는 현재 판매량보다 3~4배 높을 것으로 예상됩니다.
8. 투자관점
네패스는 국내 3대 패키징 업체 중 유일하게 고품질의 패키징을 독점 생산하는 업체인 만큼 향후 성장성에 주목해야 한다. 특히 FOPLP 분야는 국내 유일의 FOPLP 관련 업체로 삼성전자의 반도체 성장과 공존해 성장이 기대된다.

